微电子制造工艺科普(3)• 介电层沉积
评论里有童鞋觉得写浅了的,还有童鞋觉得看不懂的。。。其实我也在把握尺度问题,但本着标题里的“科普”二字,尽可能深入浅出。有些时候,作为懂的人,觉得别人也应该懂的,但其实不然,所以希望大家多多指教啦~ 如果有需求的话,我还可以在【科普文】结束后,再写【进阶篇】。
下面正文开始~
---------------------------------------------------------------------------------------------------------------------------
各位看官,现在假设你手上已经有一片硅了,我们的终极目标是在上面做出薄膜晶体管,且把它的电学性能测出来。从这篇文章开始,我们将按照工艺顺序,一篇文章一个工艺地介绍。工艺顺序是什么?请出门左转,见 微电子制造工艺科普(1)• 晶体管 - 知乎专栏 中 1.3 制造工艺部分。这里补个流程图,回顾一下。

Fig. 10 TFT制造工艺流程简图 (0)完整Si晶圆,晶圆太大了,画不下!(1)切好的Si衬底, (2)镀上SiO2介电层,(3)镀上ZnO沟道层,(4)Channel define(这个中文该怎么翻译,教教我),(5)源极漏极,(6)把栅极,也就是Si,开出来
下面介绍从(0)到(2)的过程,切割、清洗和介电层沉积。
三、切割&清洗 Cutting&Cleaning
清洗和切割就没有必要单独一篇文章叙述了。放在这里和介电层沉积一块讲。原则上,在学校的实验环境中,每一个步骤开始的时候,都是需要清洗的。
3.1 切割 Cutting
首先准备Si衬底。完整的Si晶圆都是很大一块的,比如8寸,10寸,工业界的会更大,因为晶圆越大,单个device的制造成本就越低。而就学术界来说,不需要批量生产,也碍于设备的限制,完全没有必要用大块晶圆,所以我们组一般把sample切成 1.5 X 2 cm 的大小。这个尺寸下,器件数目足够多,而且便于人工操作和机器摆放。切割纯手工,用玻璃刀,说好听点叫钻石笔,笔头确实是金刚石。。。

Fig. 11 钻石笔
3.2 清洗 Cleaning
即便是在超净间(cleanroom)的环境下,Si片表面的污染也是不可能避免的,特别是被镊子夹过的地方。所以在正式开始之前,需要清洗样品。学术界通用的简便方法就是依次用 丙酮 (acetone),甲醇(methanol),和去离子水(DI water)在超声里各振5min就行了,最后氮气吹干。超声就是眼镜店用来洗眼镜的机器。这一步在微电子制造工艺科普(2)• 光刻 - 知乎专栏微电子制造工艺科普(2)• 光刻 - 知乎专栏中有提及。而更严谨一些需要用RCA cleaning,比较复杂,【进阶篇】介绍,如果有【进阶篇】的话,恩。
丙酮:很好的有机溶剂,溶解样品上的有机物
甲醇:也是有机溶剂,且它既溶于丙酮也溶于水,可以把第一步残留的丙酮带走
去离子水:把前一步残留的甲醇和样品上的无机物带走
关于去离子水,去离子这三个字很重要,否则给器件带来的影响是灾难性的,因为电学测量结果会乱跳,毫无规律。比如,2013年我们实验室去离子水中多出了很多Cl-,导致所有工作停滞半年。这半年主要是花在查问题究竟出在哪了,因为谁都想不到会是水出了问题。
四、介电层沉积 Dielectric Layer Deposition
可以做介电层的材料有很多,Si工艺中最常用的就是SiO2。因为你再也找不出其他什么材料可以和Si有这么好的交界面了(自己和自己的氧化物交接嘛)。 除此之外,在工业界,为了适应有效沟道长度(也就是XXnm制程)越来越小的要求,SiO2的厚度已经被迫减薄到几个纳米了。由于量子力学效应,电子会发生隧穿,产生沟道到栅极的漏电,削减源极漏极间的开电流。这是我们不希望看到的。在不牺牲电容的情况下,为了让介电层变厚,只能换用高介电常数(high-k)的材料,比如Al2O3、HfO2、ZrO2等。但是Al3+,Hf4+,Zr4+有很大的可能性在高温工艺下扩散进Si,导致器件栅极天生带正电,影响开启电压和开启速度。所以换用high-k之后,交界面问题是主要聚焦研究的问题。
以上是背景介绍,现在以SiO2举例,正式讲讲这一层怎么做。在Si上生长或者沉积SiO2主要有两种方法:热学氧化 (Thermal oxidation)、和等离子体增强型化学气相沉积(Plasma Enhanced Chemical Vapor Deposition, PECVD)。各有各的优缺点,下面分别说明。
4.1 热学氧化 Thermal Oxidation
很直白,就是把清洗后的硅片放进卧式炉里,通氧气,或者通水蒸气,然后千度高温烧,表面的Si就会被氧化成SiO2了。氧化层的深度和时间是非线性关系,越深越难被氧化。
干法(Dry oxidation):通氧气高温加热。氧化层纯度高,质量好,但是氧化速度慢
湿法(Wet oxidation):通水高温加热。速度快,但是纯度不高

Fig. 12 卧式炉,把硅片推进去烤就行。注意:用热学氧化方法镀SiO2不要事先切好样品,而是把完整晶圆推进去,之后再切。卧式炉的尺寸是给完整晶圆设计的,切好后样品太小,放不成。再注意:推拉必须缓,否则温差过大,晶圆就炸了。
4.2 等离子体增强的化学气相沉积 PECVD
这中文名字有点绕,一般就叫PECVD了。这是一台真空设备,向真空腔里通入N2,用于产生等离子体。等离子体是继固液气后的第四种物质形态,又叫电浆,说白了就是正负电荷间的化学键被打断,变成一坨各种正负电荷无规律的在一块的“气体”。特点就是带有极性,而且高能,可以降低化学反应的反应温度。在等离子的帮助下,高温加热,再通入硅烷(SiH4)和笑气(N2O),二者反应,生成SiO2和NH3,那SiO2就沉积在样品上了。
这里需要注意的是,二者是气相反应,那是不是说,满真空腔就全是SiO2颗粒了呢?答案:是的。但是可以控制,让样品下方温度最高,而其他地方温度相对较低,或者冷壁,减少SiO2污染。但不管怎么说,PECVD的腔体都是很脏的。
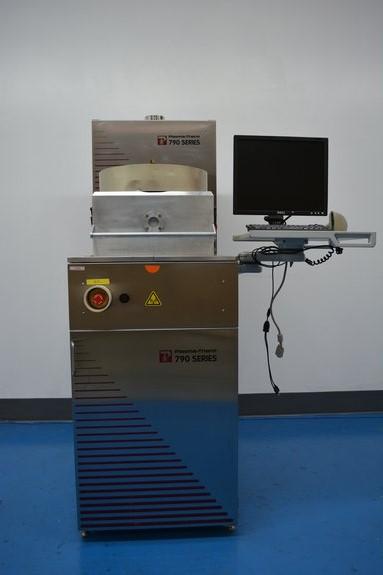
Fig. 13 PlasmaTherm 790 PECVD。本想查一下价格,都得正式询价,没查到,算了。。。
PECVD生成的SiO2在质量上不如烤出来的,原因很显然:
- PECVD SiO2是SiH4和N2O反应生成,沉积在Si表面的。而热学方法的SiO2是氧进硅片生成的。致密度上,明显烤箱做的会比PECVD好。更高的致密度,更加绝缘,更不容易漏电。
- 同一台PECVD设备不仅能长SiO2,还能长其他材料,比如SiNx等。而且放进反应腔的样品也不一定是硅片,可以是玻璃,蓝宝石,甚至是塑料。这些因素都会污染反应腔,那生长出来的氧化物也是很可能被污染的。另一方面,当然可以清洗PECVD,这是PECVD维护的一部分。
那为什么还要用PECVD呢?
- PECVD的SiO2生长速率是非常线性的,所以可以很方便地预估厚度
- PECVD生长速率比烤炉快太多,省时间
- PECVD生长成本低
介电层镀完,产生了一个问题,就是不导电的SiO2把要作为栅极的Si完全覆盖住了,最后测量电性的时候,探针扎不到了,怎么办?这一步在最后一步,也就是Fig. 10(5)-(6)中解决。简而言之,给SiO2挖一个洞就行了。等到了那一步,我们再细讲。
这期结束,下期讲我的老本行 ZnO沉积 了,白白~~

